yogesh5683
Newbie level 2
Hi everyone,
I am new on silvoco TCAD,i am designing a device on it of 32nm fgmos but the problem here is "lateral diffusion" and the junction is not finding properly,
the command i used for it is
implant arsenic dose=1e15 energy=10
pleaase suggest me proper command that i can use to implant n type material by reducing lateral diffusion for 32nm fgmos.
the output seeems like this
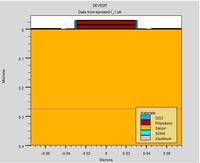
I am new on silvoco TCAD,i am designing a device on it of 32nm fgmos but the problem here is "lateral diffusion" and the junction is not finding properly,
the command i used for it is
implant arsenic dose=1e15 energy=10
pleaase suggest me proper command that i can use to implant n type material by reducing lateral diffusion for 32nm fgmos.
the output seeems like this