R1kky
Junior Member level 3
Hello, does anybody can advise what restrictions for current through vias of package substrate and so on for the bump-ball interconnections?
what parameters influence on this (max current) value (material, thickness?)?
apreciate your help.
- - - Updated - - -
as i understand there are next vias type
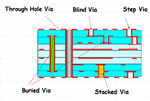
what parameters influence on this (max current) value (material, thickness?)?
apreciate your help.
- - - Updated - - -
as i understand there are next vias type